用Genesis 2000进行外层设计
前提条件
对齐层;删除了外围线和外围线外的物件;校正了孔偏(对Pad)
制作要求
1:检查线路是否补偿(少于12mil进行补偿1mil),
SMD是否需要补偿,短边小于10mil进行补偿1mil,
BGA一定要定义SMD属性(BGA少于14mil也要进行补偿1mi)。
IC测试点少于14mi进行补偿(2mil)
2:VIA,PTH孔的RING环做够要求最小4mil,最优6mil。
间距(线距,线pad,pad到pad,..)做够4mil。极限3.5mil
3:查看MI中是否有特别何必修改要求,及是否要加U-LOGO等。
公司要求
4:NPTH孔削铜单边6mil,外围是否削够单边12mil。V-cut线单边15mil.
5:特别注意是否有阻抗,如果有时则要按MI中要求制作。
6: 是否要过V-CUT,如果有则要加V-CUT测点。
如果是内存条板则对应加钻孔。
一般流程
转绿油Pad----à转线路PAD----à设置SMD属性----à转Surface(无大铜皮则省) ----à
加大线路和SMD PAD----à掏铜皮----à优化并根据优化结果修改----àNPTH孔削铜
----à削外围----à检测并根据检测结果报告修正错误
操作详解
1,转绿油Pad
右击防焊层选Features Histogramà选中线列表Line List里的物件àDFMàCleanup
àConstruct Pads by ReferenceàERF设置为Affected layeràTolerance处填的是要转
PAD的同类物件之间的大小差别数值,如1或1.5à其他不动运行即可
这里用的是手动转PAD,转完仔细查看下是否全部转为PAD?

2,转线路Pad
DFàCleanupàConstruct Pads(Auto.,all Angles)à设置参数意思如下:
ERF:选Outers Layer:选要转PAD的外层名
Reference SM:选择转好PAD的与上面外层对应的防焊层
Tolreance:大小相差不超过此值的同类要转图象将被转为同一类PAD
Minimum:要创建PAD的最小尺寸,用来过滤掉做为PAD的小细线的标识
Maximum:要创建PAD的最大尺寸,用来过滤掉标识为PAD的大铜皮
其他一般不用设置,每次只是转一层,因为这里用的参考转PAD,同样转完要查看

3,设置SMD属性

目的是防止用来贴片的PAD被系统乱改动,因为这种PAD没钻孔对应,只是用来在上面以贴片的形式把电子元件焊上去。
影响外层两层àDFMàCleanupàSet SMD AttributeàERF:选Non Drilledà
Layer:换成 .affectedà其他不动运行即可
注意:象光学点、BGA之类的圆形PAD用上面的功能无效,要另外手动添加。
大致方法如下:
选中要设置的PADàEditàAttributesàChangeà在弹出窗口中点Attributesà
在弹出窗口中点选.SMD再点Add,Closeà点OK即可
4,转Surface 如果没有大铜皮则此步可省
选中要转的大铜皮àEditàReshapeàContourize…参数不用设置直接点OK即可
选大铜皮可双击铜皮内的线或ActionsàSelect Drawn。。。,关键是不要把不是铜皮的物件也选进来了

5,加大线路和SMD PAD
选中要补偿的线路(比如要求小于15mil的线路就要补偿)àEditàResizeàGlobal…
在参数Size后填1点OK即可,因为一般只要求补偿1mil(在原来的基础上整体加大)
注意:有的MI中有最小线宽要求,对于那些没达到最小值的线只有直接改为最小值
常用EditàReshapeàChange Symbol
加大SMD PAD 方法同上,只不过先要选中SMD PAD,这个可以通过物件过滤器
(窗口右边上面有?号的哪个图标),里面有个User Filter按钮,里面可以把影响层内
带SMD属性的所有PAD选中(点选Select SMD Pad再点OK)
6,掏铜皮
先查看各种物件到铜皮的距离是否够要求,有不够的地方才要此步
A> 选中铜皮àMoveàOther LayeràTarget layer:填个即将要创建的层名点OK即可
B> 利用参考选择选中钻孔层没与铜皮接触的孔,加大足够大小转为负的复制到上面刚建立的层上去即可,常用命令EditàCopyàOther Layer
C> 然后后把原来被移走铜皮的层上的物件移到刚建立的层上来
D> 与原稿核对,认为掏够距离后,覆盖到被移走物件的层即可,用<M2>拖放
7,优化并根据结果修改
设置好影响层àDFMàOptimizationàSignal Layer Optimization

本操作是按设定的参数对信号层进行优化,它自动会削Pad来解决间距问题,同时保持足够的焊环宽度;还会对线路重新布线以及其他修改.当然对无法自动修补的但又违反参数设置的地方也会在报告里说明,我们可以配合结果查看器给予手动修改
.
(1) 参数设置
ERF: Inner Layers Signal Layer: .affected
PTH AR Min: 7 Opt: 8 设置PTH孔令环的最小值和最佳值
VIA AR Min: 3 Opt: 6 设置导通孔令环的最小值和最佳值
Spacing Min: 4 Opt: 4 欲维持的最小间距和最佳间距
Drill to Cu: 10 钻孔边到铜箔间的距离
Modification: PadUp Shave
选择修正错误的方式:我们只选加大Pad和削Pad两种就够
其他参数一般都不调整,最好是先把最小间距设为0.1后去优化(让Pad尽量加大)再设回4去优化.
(1) 报告结果
ARG Violation 违反最小令环值但无法自动修补
ARG Violation(OPT) 违反最佳令环值但系统无法修补
Spacing Violation 间距不足最小值
Spacing Violation(OPT) 间距不足最佳值
H2Cu Violation 孔边到铜箔的距离不够
Unfillable Polygon Shave 无法将Polygon Shave t填成线
Pad Enlarge>limit AR加大值超出界限,所以没加大
Same Net Space AR加大后会造成同NET间距不够,所以没加大
这里只列出违规报告项目,报告项目含义可以自己在练习的时候通过查看违规图样去加深体会;在报告中的什么错误怎么手动修改,也只有靠自己去多练习多总结经验,不能一一列举.
8,NPTH孔削铜 (同内层正片的Npth孔削铜)
先看NPTH孔到铜边的距离是否达到要求,没达到就加大NPTH孔用负的去反掏
9,削外围
(1) 选中外围线àEDITàReshapeàChange Symbol…
.输入r30点OK,就把外围加大到30mil(Resize 操作是在原来基础上加大,而这里是加大到多少)加大到多少视具体情况而言(本操作同样适用于其他层的设计)
(2) 把加大的外围线跟要削的层比较,看是否会削掉有用的东西,如会则酌情处理
(3)选中加大后的外围àEDITàCopyàOther Layer…
Destination:视情况选择,如果你一层层削外围,则可选Layer Name:然后在下面输入层名即可,如果选Affected Layers则必须在把影响层设置好,这时可以削比较好后的几个层次.
Invert:转换极性用,象现在削内层正片,就必须把外围转成负的去削,所以选Yes
如果削负片的外围是用正的去削,选No
(4)下面参数一般都不设置,点OK即可.值得注意的是,Resize By:是在原来基础上加大多少的意思.要设置的话一定要弄清楚再填数字.
10,检测并根据结果修正 AnalysisàSignal Layer Checks…

本操作是用来查帐信号层和混合层潜在的工艺性缺陷,并生成统计报告.所以本操作不 会去自动修改.
(1) 参数设置(稍微比优化时的数值大点,以便让系统全部检测到,然后根据结果对报告有问题的地方去做手动修改)
ERF: Inner Layer: .Affected
Spacing: 定义各种物件之间的间距的搜寻半径
Rout to Cu: 定义成型线到铜边的搜寻半径
Drill to Cu: 定义钻孔边缘到铜边的搜寻半径及最大的AR
Sliver Min: 会被报告的最大细线宽度
Test List: 检查项目
Spacing √ 报告各种物件之间的间距的违规
Size √ 报告各种物件的大小
Drill √ 与钻孔有关的报告
Sliver √ 报告细线
Rout √ 与成型有关的报告
SMD 报告与SMD有关的东西
Check Missing Pads For Drills: 是否测量缺Pad
Use Compensated Rout: 是否要锣刀补偿
Sort Spacing By Solder Mask: 是否区分被防焊覆盖或未覆盖
(2) 报告结果
报告结果一般都很多,报告项目格式一般是:
问题描述(检查项目类别) 例如:SMD to SMD(Spacing)为SMD到SMD的距离
列表如下:
[具体意思自己在练习中结合图形体会,同时也可参考Genesis2000基础培训教程]
常见报告结果图例 qPad to Pad (Spacing): Pad 到 Pad 的距离

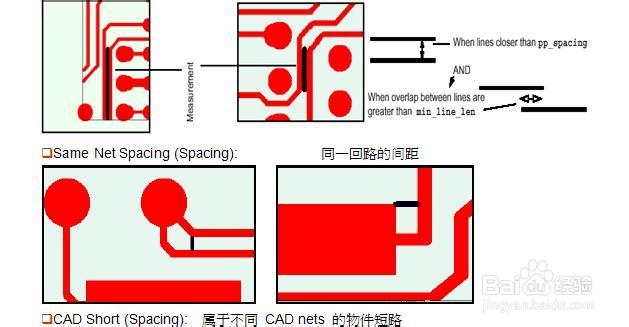
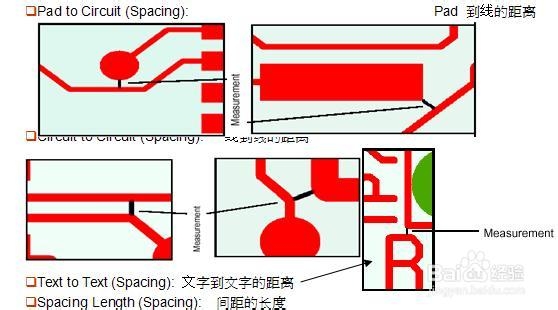
qCAD Short (Spacing): 属于不同 CAD nets 的物件短路
qCAD Self Spacing (Spacing): 属于同 CAD net 的物件没接触但距离太近


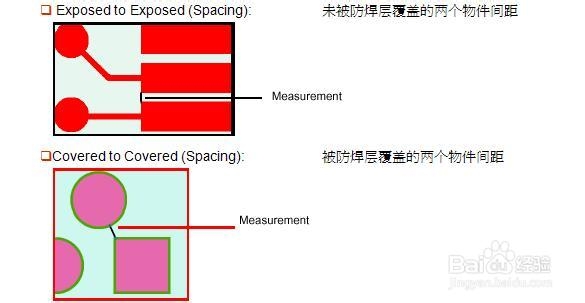
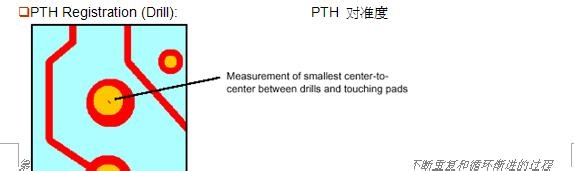


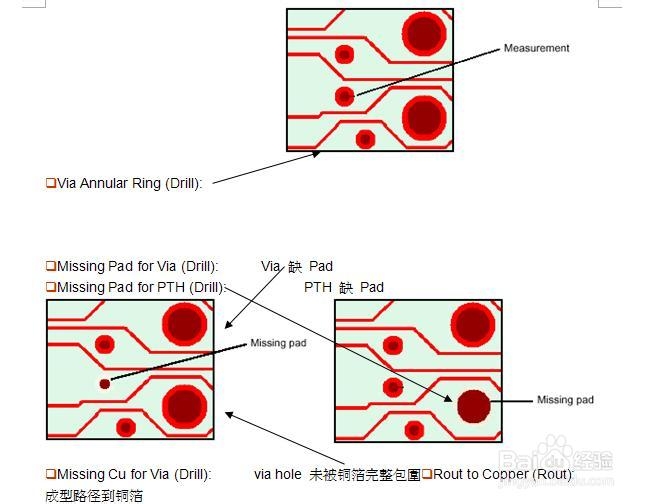
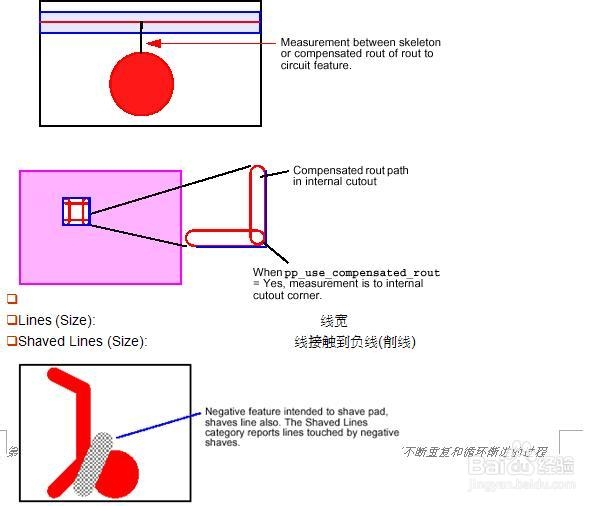
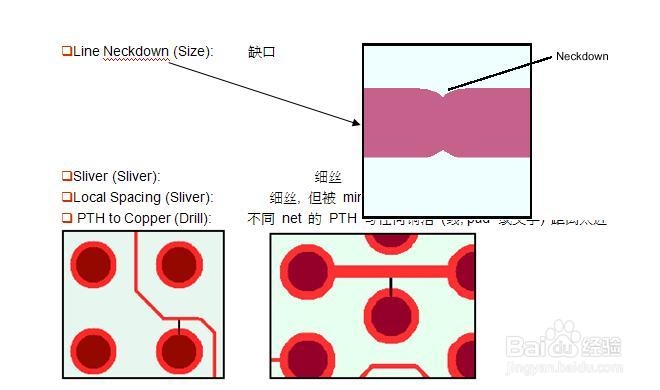
附:
一、物件过滤器选SMD Pad
